随着系统集成封装(SIP)技术发展,嵌入式薄膜电阻需同时满足高方块电阻(>100 Ω/sq)和近零电阻温度系数(│TCR│<50 ppm/K)的严苛要求。传统NiCr电阻因低方块电阻(通常<50 Ω/sq)和TCR正偏移难以达标。本实验借助xfilm离线半自动四探针测试技术,精准量化薄膜电阻的电学性能,结合磁控溅射工艺研究了铝Al插入层厚度、NiCr电阻层厚度以及退火工艺对Al/NiCr双层薄膜方块电阻(Rₛ)和电阻温度系数(TCR)的影响。
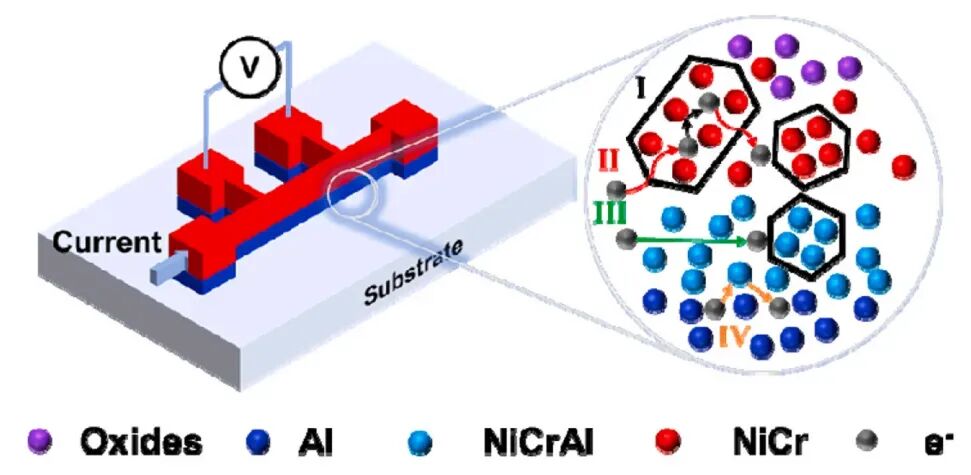
Al/NiCr双层薄膜中电子传输行为示意图
实验方法
/Xfilm
样品制备
- 磁控溅射法:在Al₂O₃基板上沉积Al(0-10 nm)/NiCr(5-20 nm)双层薄膜,溅射速率(Al: 0.05 nm/s, NiCr: 0.073 nm/s)。
- 对比组:制备NiCr/Al(Al作为顶置层)结构,验证Al夹层的关键作用。
- 退火工艺:部分样品在真空环境下300°C退火1小时。
测量方法
- 方块电阻:采用四探针结合霍尔棒结构测量,避免接触电阻干扰。
- TCR测试:−55°C至125°C循环测量,每25°C恒温5分钟,计算TCR:

- 材料表征:AFM(表面粗糙度)、XRD(晶体结构)、HRTEM与EDS(元素扩散)。
铝插入层厚度对电学性能的影响
/Xfilm

Al插入层厚度对Al/NiCr双层薄膜电学性能的影响(a)-(c) 方块电阻;(d)-(f) TCR
- 方块电阻Rs
当铝夹层厚度tAl从 2.5 nm 增加至 7.5 nm 时,Al/NiCr 双层薄膜的方块电阻Rs呈现先增后减的趋势,在tAl=5nm时达到峰值(265.95 Ω/sq,tNiCr=10 nm,300℃退火)。这一现象归因于界面扩散与晶粒尺寸效应:> 当tAl<5nm时,退火促进 NiCr 结晶,缺陷减少导致Rs下降;> 当tAl≥5 nm时,Al-NiCr 互扩散形成 15 nm 厚的 NiCrAl 中间层,同时 NiCr 层 内小晶粒增多(晶粒尺寸 < 10 nm),晶界散射主导使Rs显著提升;> 当tAl>7.5 nm时,Al 层成为主要导电通道,导致Rs下降。
- 电阻温度系数TCR调控:
Al夹层使TCR 随tAl增加呈现“先降后升”趋势,在tAl= 7.5 nm时达到最低值 - 6.61 ppm/K(tNiCr=10nm,400℃退火)。
退火工艺的界面效应
/Xfilm
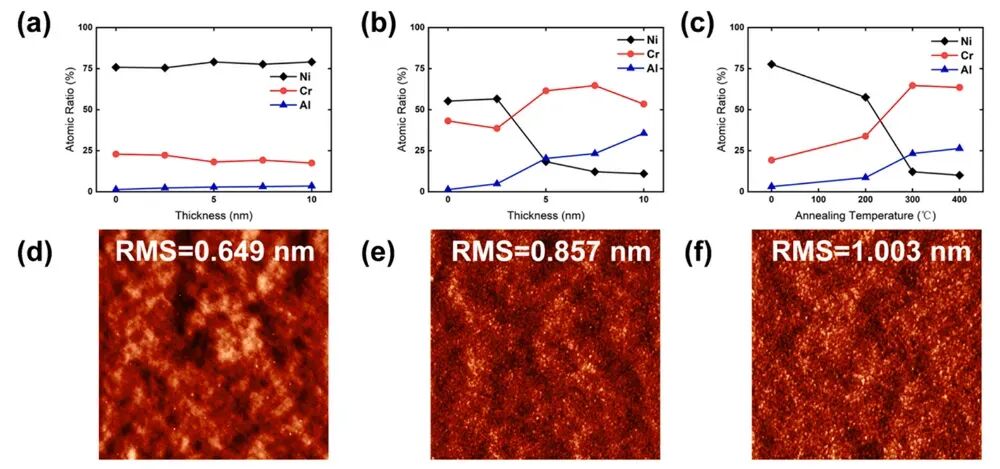
Al/5 nm NiCr双层薄膜的表面成分与形貌分析

Al/NiCr双层薄膜的X射线衍射(XRD)图谱表面成分(XPS):300°C退火后,Al向NiCr层扩散,形成Al-O/NiCr混合界面(抑制NiCr氧化)。微观结构(HRTEM):

7.5 nm Al/20 nm NiCr双层薄膜的横截面显微结构分析
未退火样品:Al/NiCr界面清晰。退火后:界面处生成非晶态Al₂Oₓ扩散阻挡层(厚度~2 nm),减少晶格失配应力。电阻稳定性:退火后Rₛ略微下降(5.3%),但TCR优化幅度更大。
Al夹层与顶置结构的对比
/Xfilm

Al顶置层厚度对NiCr/Al双层薄膜电学性能的影响(a)-(c) 方块电阻;(d)-(f) TCR
设计 NiCr/Al 对照组(Al 层位于上方)发现,其Rs随tAl增加单调下降,TCR 负移幅度显著小于 Al 插入层结构。这是由于覆盖层 Al 无法有效诱导 NiCr 层内的晶粒细化与界面扩散,且自身高导电性会降低整体阻值。该对比证实了中间层位置对界面调控的决定性作用—— 底部 Al 层通过晶格失配与扩散源双重机制,显著提升调控效率。
性能优化与应用潜力
/Xfilm
通过正交实验确定最优工艺窗口:tAl=5~7.5nm,tNiCr=10~20 nm,退火温度 300~400℃。在此范围内,可获得:
- 方块电阻范围:93.34~1439.01 Ω/sq(覆盖嵌入式电阻器的典型需求);
- TCR 范围:-6.61~+78.81 ppm/K(近零 TCR 精度达 ±10 ppm/K)。
与商用产品相比,本研究材料在高阻区(>200 Ω/sq)和 TCR 稳定性方面具有显著优势。

400℃退火后的薄膜仍保持低 TCR(-8.06 ppm/K)和高方阻Rs(208.39 Ω / sq ),满足 CMOS 后端工艺的热稳定性要求。此外,Al 的低成本与磁控溅射的大面积沉积能力,为规模化生产提供了工艺基础。通过磁控溅射法制备不同结构的Al/NiCr双层薄膜,采用四探针法测量方块电阻,结果显示7.5 nm Al夹层可使20 nm NiCr薄膜的Rₛ提升至265.95 Ω/sq,同时TCR优化至−6.61 ppm/K;300°C退火后,Al/NiCr界面反应形成扩散阻挡层,有效降低TCR,为高精度薄膜电阻器件的优化提供实验依据。
xfilm离线半自动四探针
/Xfilm

xfilm离线半自动四探针是专为科学研究设计的方阻测试仪,可以对最大450mm * 400mm 样品进行快速、准确的测试, 获得样品不同位置的方阻/电阻率信息。
- 超宽测量范围:1 mΩ~100 MΩ;
- 最大样品尺寸:450 mm*400 mm;
- 测量精度:0.1%(标准电阻片,带第三方检测认证);
- 重复性:在测量标准电阻片时,测量重复性为<0.2%
本文更通过xfilm离线半自动四探针的高精度数据采集为薄膜电阻的工业化参数设计提供了可靠依据,为嵌入式电阻和半导体集成提供了兼具性能突破与工艺可行性的解决方案。
原文参考:《Achieving high sheet resistance and near-zero temperature coefficient of resistance in NiCr film resistors by Al interlayers》
*特别声明:本公众号所发布的原创及转载文章,仅用于学术分享和传递行业相关信息。未经授权,不得抄袭、篡改、引用、转载等侵犯本公众号相关权益的行为。内容仅供参考,如涉及版权问题,敬请联系,我们将在第一时间核实并处理。
